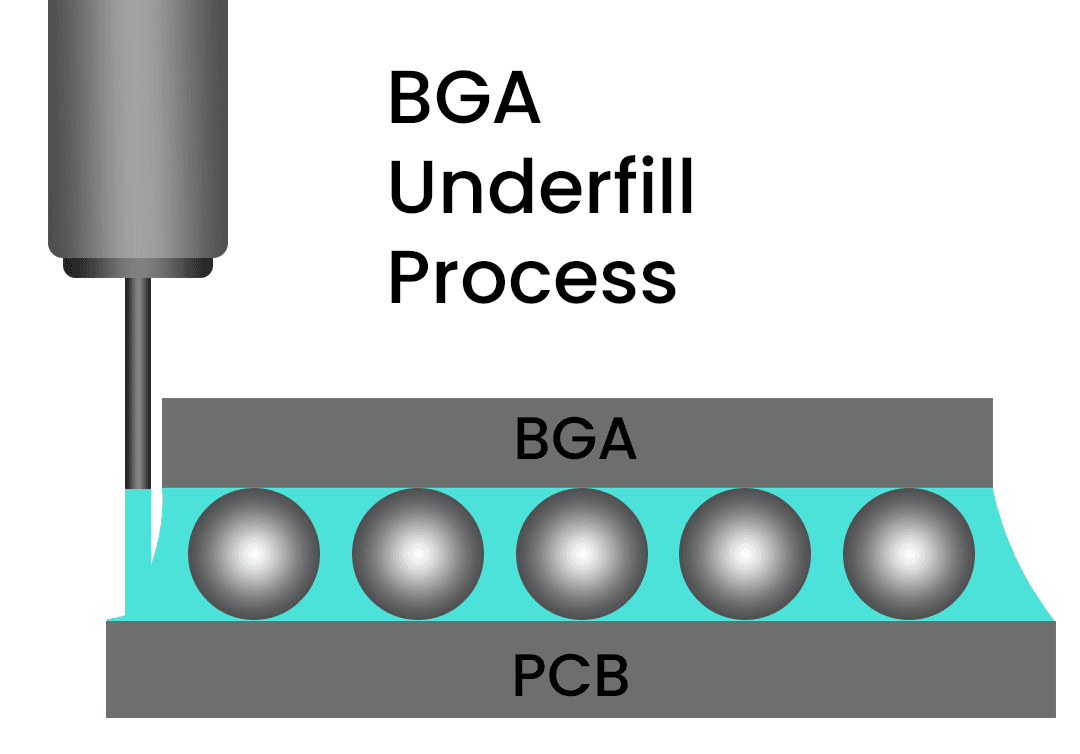
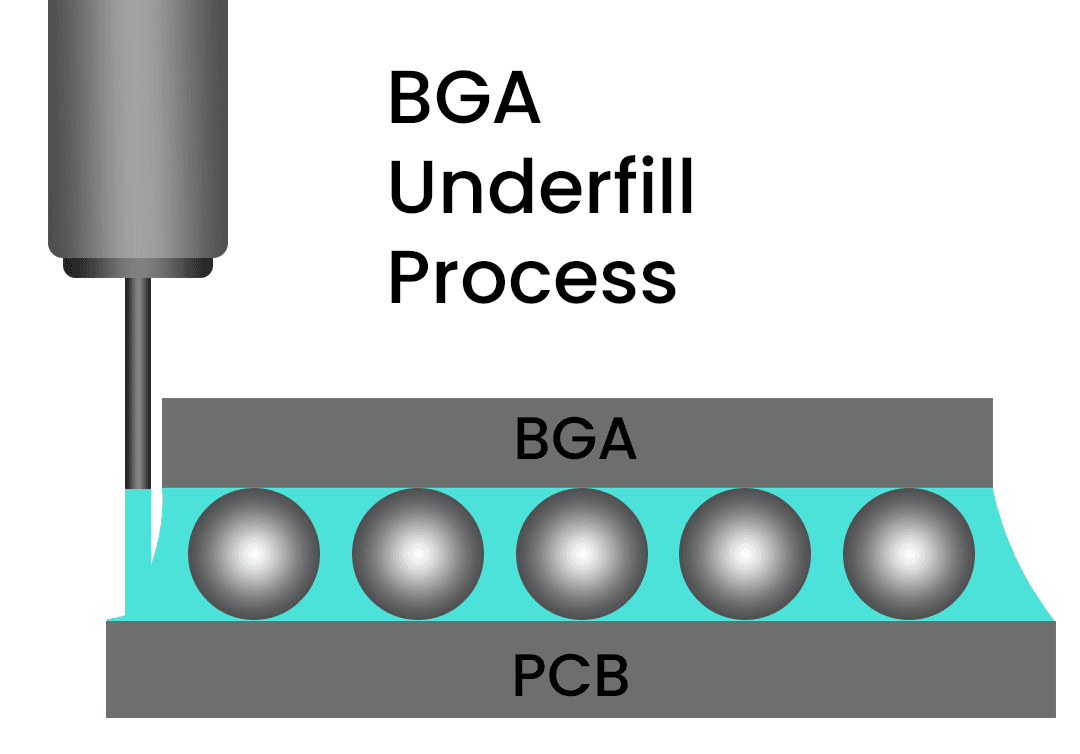
BGA underfill is an adhesive material applied beneath the BGA chip to bond it securely to the printed circuit board (PCB). It flows under the chip during assembly and cures to form a strong bond. Underfill compensates for the coefficient of thermal expansion (CTE) mismatch between the BGA and the PCB, reducing the risk of solder joint failure.
Ball Grid Array (BGA) devices are widely used in modern electronics assemblies due to their compact size and high pin count. However, their reliability can be affected by factors such as thermal cycling, mechanical stress, and solder joint fatigue. BGA underfill is an effective solution to enhance the mechanical or thermo-mechanical reliability of these assemblies.
BGA Underfill Using GPD Global’s Dispensing Equipment Provides Enhancing Reliability in Electronics Assembly
Selecting the Right Underfill -Choosing the correct underfill is crucial for optimal reliability. Consider the following factors:
BGA underfill significantly enhances the reliability of electronic assemblies. By carefully selecting the right underfill material and application method, manufacturers can improve the longevity and performance of BGA-based products.
GPD Global’s BGA underfill process is a vital method that guarantees strong connections and long-lasting performance in contemporary electronic devices.
Read more about ‘what is underfill’ and the capillary underfill dispensing process.